FOPLP正在快速推进。
据《日经新闻》报道称,台积电正在最终确定其FOPLP技术的规格,以加快量产时间表。预计第一代FOPLP技术将采用300毫米x 300毫米的面板尺寸,小于之前测试的510毫米 x 515毫米尺寸。
据报道,台积电目前正在台湾桃园建设一条试点生产线,预计最早将于2027年开始小规模试生产。这也表明,FOPLP发展将进入快车道。
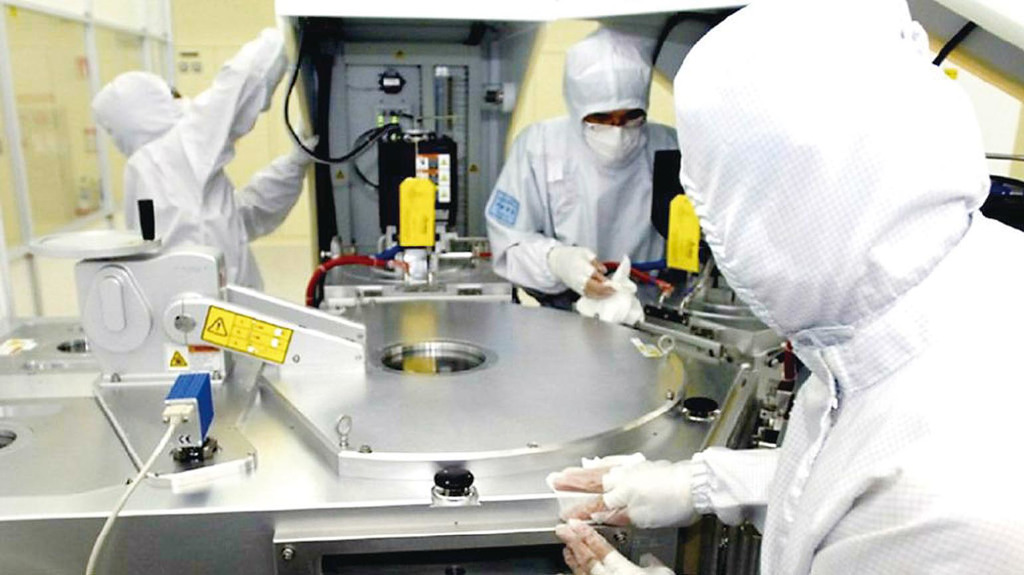
FOPLP技术兴起
FOPLP(Fan-Out Panel Level Packaging)是一种先进的半导体封装技术,通过在大尺寸矩形面板上进行芯片封装,相较于传统的圆形晶圆封装,FOPLP在封装面积和成本效益方面具有显著优势。此技术特别适用于高性能计算和AI芯片的封装需求。
传统的扇出型封装多为圆片级(FOWLP),其封装尺寸受限于晶圆尺寸(通常为300mm)。FOPLP则是将封装基底从晶圆扩展到大型矩形面板(如600mm×600mm),具有诸多优势。
一是更高产能与良率控制能力:FOPLP使用矩形玻璃或有机基板,每片面板可封装更多芯片,减少边缘浪费,显著提升单位面积利用率;二是成本下降空间大:与圆片级扇出封装相比,FOPLP在封装尺寸、批量处理能力等方面更具规模效应,有望在中高端市场实现替代;三是异质集成支持更强:FOPLP在封装过程中可支持多芯粒、多功能模块集成,可适配AI SoC、汽车电子等复杂封装需求。

根据Yole Intelligence、TechInsights等研究机构预测,2023年全球FOPLP市场规模仅为3亿美元左右,处于试产导入期;2025-2027年将进入量产导入高峰,预计2027年达到15亿美元以上;到2030年,FOPLP有望占据整体Fan-Out封装市场约30%的份额。
玻璃基板为挑战突破口之一
可以看到,FOPLP并非简单用于成本降低,更是为多芯片互联、高速I/O、高频信号等后摩尔时代应用需求而生。
因而,FOPLP的应用将逐步渗透至以下场景:一是AI加速芯片:需高带宽、高I/O封装能力,FOPLP有望承载部分中端AI推理芯片封装需求二是5G射频前端模块(RFFE):天线与PA/LNA集成度提升,对封装面积和热管理要求高,FOPLP结构更灵活;三是AR/VR与可穿戴设备:空间受限但需高集成度,FOPLP可整合更多异质功能芯片;四是车用电子:未来有望用于ADAS与中级域控制器封装。
尽管FOPLP在技术上具有诸多优势,但在实现大规模量产方面仍面临一些挑战。
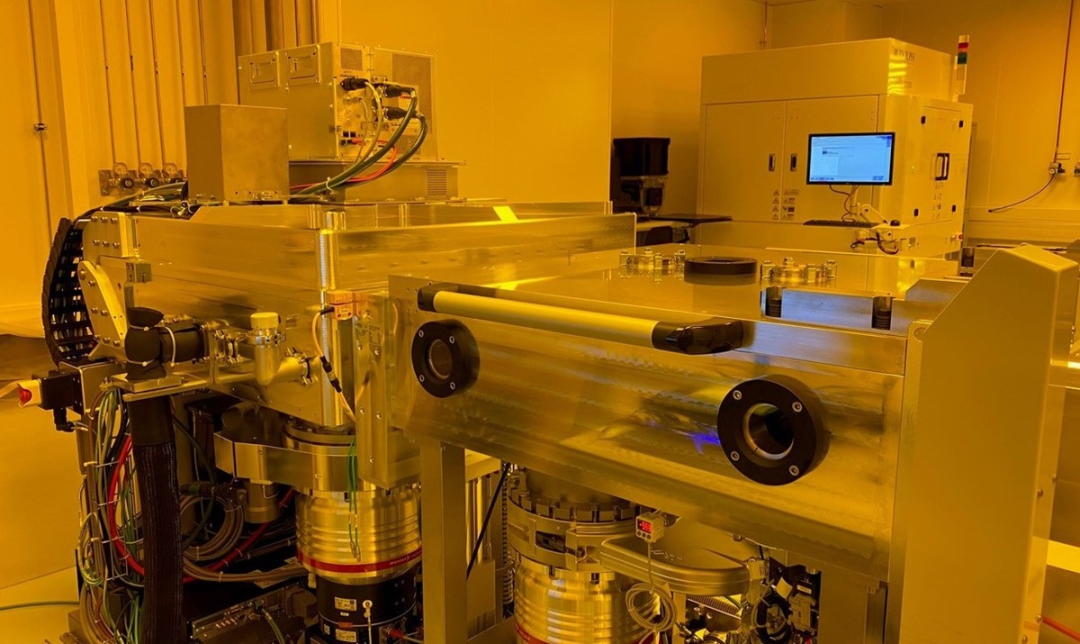
有分析称,挑战涉及大尺寸面板翘曲与应力控制难度高;基板材料(玻璃、有机)选择尚未统一,兼容性待验证;封装工艺设备如RDL、激光剥离、面板贴片未完全标准化,需大规模验证支撑投资回报;良率与可维修性相比晶圆级仍待提升等。
有建议称,突破口在于引入玻璃基板,以提升热稳定性与尺寸稳定性。此外,可与AI/车用芯片客户共同开发定制封装结构等等。
与目前使用的有机基板相比,玻璃基板具有优异的机械、物理和光学性能,可以在封装中连接更多的晶体管,提供更好的可扩展性,并组装更大的SoC。伴随着先进封装潮起,可以说玻璃基板已成为重塑产业格局、决定未来胜负的重要战场。
据Prismark统计,预计2026年全球IC封装基板行业规模将达到214亿美元。The Insight Partners认为,玻璃基板的全球市场规模预计到2034年将突破42亿美元。
巨头争霸玻璃基板
作为下一代高密度、高频封装载体材料,全球多个头部企业与产业链环节参与者已展开玻璃基板的布局与推动,期望拔得头筹。
在1月的CES 2024上,三星电机已提出,今年将建立一条玻璃基板原型生产线,目标是2025 年生产原型,2026年实现量产。京东方、台积电、群升工业、安普电子等也在积极探索玻璃基板技术。

在芯片设计方面,AMD、英伟达等正积极进行芯片产品导入玻璃基板测试;康宁、旭硝子、肖特均具备高精度玻璃晶圆或基板供应能力;在激光通孔业务上,LPKF、Samtec等厂商能够提供成熟的激光通孔(TGV)解决方案。
如英特尔已明确宣布计划未来几年将玻璃基板导入其高端AI/HPC芯片的封装平台,用于支持更大面积的Chiplet互连与更高密度的I/O架构。三星旗下的封装子公司SEMCO积极投入FOPLP技术开发,全面押注玻璃面板级封装平台。欧洲封装与基板大厂AT&S也正在投资建设玻璃基板中试平台,配合其未来高频高速封装战略。
从国内来看,沪电股份、华正新材、生益科技等龙头企业正投入资源研发高性能玻璃基材料与匹配加工工艺,力争在玻璃基板新一轮竞赛中保持优势。
随着AI、HPC、服务器SoC等对高密度、高平整、高信号完整性封装需求飙升,玻璃基板也将在未来几年迎来爆发。而谁率先完成量产工艺突破与规模供应,谁将在未来封装市场掌握更多话语权。
从验证走向量产的“临界点”
尽管面临诸多挑战,但随着技术的不断进步和市场需求的推动,FOPLP有望在未来成为主流的先进封装解决方案之一。一些产业前锋已在排兵布阵,FOPLP已由技术验证期进入小规模量产和应用导入期。
除台积电加速推进其FOPLP技术的量产计划之外,包括三星、日月光以及大陆一些厂商也在积极布局。

据悉,台积电最初曾考虑与群创光电等面板制造商合作,但最终选择自行开发该技术,因为其认为目前面板行业的精度和技术能力不足以满足台积电的标准。
最近有报告指出,与晶圆上晶圆(WoW)、CoWoS 和 SoIC等3D堆叠技术相比,FOPLP的散热性能有所提升。然而,其生产效率低于现有的3D堆叠方法。
可以说,FOPLP既是先进封装效率与成本优化的结果,也是后摩尔时代多芯片、异质集成趋势的自然选择,围绕FOPLP的争夺,产业链也将迎来一场大战。

